要約
このアプリケーションノートでは、RFプリント回路基板(PCB)の設計とレイアウトについてガイドラインと推奨事項を示し、ミックスドシグナルアプリケーションについても取り上げます。この文書では「ベストプラクティス」の指針も紹介します。このアプリケーションノートは、該当する特定の部品、PCBメーカー、一連の材料に適用可能な他のすべての設計および製造ガイドラインと組み合わせて使用する必要があります。
このアプリケーションノートは、マキシムのワイヤレス製品すべてに適用されます。
目次
- はじめに
- RF伝送ライン
- 信号ラインの絶縁
- グランドプレーン
- バイアス層とグランド層に関する特別な考慮事項
- 電源(バイアス)の配線と電源デカップリング
- デカップリングまたはバイパスコンデンサの選択
- バイパスコンデンサのレイアウトに関する考慮事項
- シャント接続部品の接地
- ICのグランドプレーン(「パドル」)
はじめに
このアプリケーションノートでは、RFプリント回路基板(PCB)の設計とレイアウトについてガイドラインと推奨事項を示し、デジタル、アナログ、RF部品を同一PCB上に実装するケースなど、ミックスドシグナルアプリケーションについても取り上げます。この文書はトピック分野ごとに整理されており、「ベストプラクティス」の指針も紹介します。このアプリケーションノートは、該当する特定の部品、PCBメーカー、一連の材料に適用可能な他のすべての設計および製造ガイドラインと組み合わせて使用する必要があります。
RF伝送ライン
マキシムのRF部品の多くには、PCB上のICピンに出入りするRF電力を伝送する、インピーダンスの管理された伝送ラインが必要です。これらの伝送ラインは、外層(最上層または底層)で実装されるか、内層に埋め込まれます。これらの伝送ラインのガイドラインには、マイクロストリップ、サスペンデッドストリップライン、共平面導波路(接地型)、および特性インピーダンスに関連した議論が含まれます。また、このガイドラインでは、伝送ラインの屈曲とコーナー補償や、伝送ラインの層変更についても説明します。
マイクロストリップ
このタイプの伝送ラインは固定幅の金属配線(導体)と、その直下(隣接層)に配置された切れ目のないソリッドグランドプレーンで構成されます。たとえば、第1層(最上層の金属)のマイクロストリップでは、第2層にソリッドグランドプレーンが必要です(図1)。配線の幅、誘電体層の厚さ、および誘電体のタイプによって、特性インピーダンスが決まります(通常、50Ωまたは75Ω)。
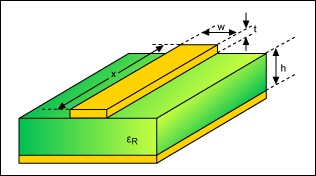
図1. マイクロストリップの例(等角図法)
サスペンデッドストリップライン
このラインは内層の固定幅の配線と、中心導体の上下に配置されたソリッドグランドプレーンで構成されます。導体は2つのグランドプレーンの中間に配置される場合や(図2)、オフセット配置される場合があります(図3)。これは内層のRF配線に適した方式です。

図2. サスペンデッドストリップライン(端面図)

図3. オフセット配置のサスペンデッドストリップライン。各層の厚さが等しくないPCBで使用されるストリップラインの一種(端面図)
共平面導波路(接地型)
共平面導波路は、近隣のRFラインや他の信号ライン間の絶縁性に優れています(端面図)。この伝送路は中心導体と、その両側および下に配置されたグランドプレーンで構成されます(図4)。
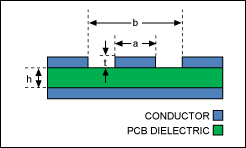
図4. 近隣のRFラインや他の信号ライン間の絶縁性に優れた共平面導波路
図5に示すように、共平面導波路の両側にビア「フェンス」を設けることが推奨されます。この上面図は、中心導体の両側、最上層の各金属グランドプレーン上に一連のグランドビアを設けた例を示しています。最上層で誘導されたリターン電流が下にあるグランド層に短絡されます。

図5. 共平面導波路の両側に推奨されるビアフェンス
特性インピーダンス
信号導体ラインの幅を正しく設定して目的のインピーダンスを実現するために利用可能な計算法はいくつかあります。しかし、各層の誘電率を入力する際は注意する必要があります。標準的なPCBの外面にあるラミネート層は、多くの場合、基板のコアよりもガラスの含有率が小さいため、誘電率が低下します。たとえば、FR4のコアでは一般にεR = 4.2となりますが、外面のラミネート(プリプレグ)層ではεR = 3.8が標準的です。下に挙げた例はあくまで参考用ですが、金属厚として1オンス銅厚(1.4ミル、0.036mm)が想定されています。
| Media | Dielectric | Layer Thickness in mils (mm) | Center Conductor in mils (mm) | Gap | Characteristic Impedance |
| Microstrip | Prepreg (3.8) | 6 (0.152) | 11.5 (0.292) | N/A | 50.3 |
| 10 (0.254) | 20 (0.508) | 50.0 | |||
| Diff. Pair | Prepreg (3.8) | 6 (0.152) | 25 (0.635) | 6 (0.152) | 50.6 |
| Stripline | FR4 (4.5) | 12 (0.305) | 3.7 (0.094) | N/A | 50.0 |
| Offset Stripline | Prepreg (3.9) |
6 (0.152) upper, | 4.8 (0.122) |
N/A | 50.1 |
| 10 (0.254) lower | |||||
| Coplanar WG | Prepreg (3.8) |
6 (0.152) | 14 (0.35) | 20 (0.50) | 49.7 |
伝送ラインの屈曲とコーナー補償
配線上の制約のために伝送ラインを曲げる(伝送方向を変える)必要があるときは、中心導体の幅に比べて少なくとも3倍の曲げ半径を使用します。言い換えると、次の条件を適用します。
曲げ半径 ≥ 3 × (ライン幅)
これによって、屈曲部における特性インピーダンスの変化が最小限に抑えられます。
ゆるやかに曲げることが不可能である場合、伝送ラインを(曲線状ではなく)直角に曲げることもできます。図6を参照してください。ただし、この場合は、屈曲部における有効ライン幅の局所的な増大によって生じるインピーダンスの不連続性を低減するための補償が必要です。標準的な補償方式は、下に示すような斜めに切り落とす方法です。マイクロストリップを直角に曲げた場合の最適な切り落とし幅は、DouvilleとJamesの式で与えられます。

ここで、Mは屈曲部で切り落とさない場合の幅に対する、切り落とした後の幅の割合(%)です。この式は誘電率とは無関係であり、w/h ≥ 0.25という制約条件が課せられます。
他の伝送ラインにも同様な方式を適用することができます。適正な補償に関して不確定な要素がある場合、高性能な伝送ラインを必要とする設計では、電磁シミュレータを使用して屈曲を模擬する必要があります。
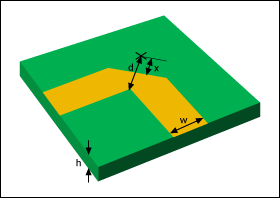
図6. 曲線状に曲げることが不可能である場合、伝送ラインを直角に曲げることも可能
伝送ラインの層変更
レイアウト上の制約のために伝送ラインを別の層に移行させる必要がある場合は、ビアのインダクタンス負荷を最小限に抑えるため、移行ごとに2つ以上のビアホールを使用することが推奨されます。一組のビアによって移行のインダクタンスが実質的に50%削減されます。伝送ラインの幅に見合った最大径のビアを利用する必要があります。たとえば、15ミルのマイクロストリップラインでは、ビアの直径(めっき仕上げ後の直径)を15~18ミルにします。スペースの制約のために大きなビアを使用することができない場合は、直径の小さな3つの移行ビアを使用する必要があります。
信号ラインの絶縁
信号ライン間の意図しない結合を防止するために注意する必要があります。考えられる結合とその防止策の例をいくつか挙げます。
- RF伝送ライン:ライン同士はできる限り引き離す必要があります。また、長距離にわたって近接に配線しないようにします。並行したマイクロストリップライン間の結合は、ライン同士の間隔が減少し、並行した配線の距離が長くなるにつれて増大します。ラインが別々の層で交差する場合、グランドプレーンを設けて切り離す必要があります。搬送する電力のレベルが高い信号ラインは、可能な場合、必ず他のすべてのラインから引き離します。接地した共平面導波路は、ライン間の絶縁性に優れています。小さなPCB上のRFライン間で約-45dBを超える絶縁を達成するのは、現実的ではありません。
- 高速デジタル信号ライン:これらのラインは、結合を防止するため、RF信号ラインとは異なる層で別個に配線する必要があります。(クロックやPLLなどからの)デジタルノイズがRF信号ラインに結合し、変調されてRF搬送波に乗る可能性があります。また、場合によっては、デジタルノイズがアップコンバートまたはダウンコンバートされることもあります。
- VCC/電源ライン:これらは専用の層で配線する必要があります。適切なデカップリング/バイパスコンデンサをメインのVCC分配ノードやVCC分岐に配置します。バイパス容量の選択は、RF ICの総合的な周波数応答、およびクロックやPLLからのあらゆるデジタルノイズの予想される周波数分布特性に基づいて行います。これらのラインも、大量のRF電力を伝送するすべてのRFラインから切り離す必要があります。
グランドプレーン
第1層がRF部品と伝送ラインに使用されると仮定した場合、推奨される手法は、第2層でソリッド(連続)グランドプレーンを使用することです。ストリップラインやオフセット配置のストリップラインでは、中心導体の上下にグランドプレーンが必要です。これらのプレーンは、信号や電源の配線と共有したり、それらの配線に割り当てたりせず、グランドにのみ割り当てる必要があります。設計上の制約から、ある層で部分的なグランドプレーンをすべてのRF部品や伝送ラインの下に設けなければならない場合もあります。グランドプレーンは、伝送ラインの配線下では途切れないようにする必要があります。
層間のグランドビアは、PCBのRF部分全体にわたって自由に追加してください。これは、グランド電流のリターン経路による寄生的なグランドインダクタンスの発生防止に役立ちます。これらのビアは、PCB全体でRFやその他の信号ラインからのクロスカップリングを防止する上でも役立ちます。
バイアス層とグランド層に関する特別な考慮事項
システムバイアス(DC電源)とグランドに割り当てる層は、部品のリターン電流の面から検討する必要があります。一般的な指針は、バイアス層とグランド層の間の層に信号を配線しないことです

図7. 層の誤った割り当て:バイアス層とグランド層のグランド電流リターン経路との間に信号層があります。バイアスラインのノイズが信号層に結合する可能性があります。

図8. 層の正しい割り当て:バイアス層とグランドリターン層の間に信号層がありません。
電源(バイアス)配線と電源デカップリング
部品に複数の電源接続がある場合、一般的な手法は、電源経路に「スター」構成を使用することです(図9)。スターの「根元」には大型のデカップリングコンデンサ(数十µFds)を実装し、スターの分岐にはそれぞれ比較的小型のコンデンサを実装します。これらの小型コンデンサの容量は、RF ICの動作周波数範囲や、コンデンサの具体的機能(段間のデカップリングか、主電源のデカップリングか)によって変わります。下に一例を示します。

図9. 部品に複数の電源接続がある場合、電源経路をスター構成で配置可能 詳細画像
「スター」構成では、同じバイアス配線に接続されたすべてのピンを直列に接続した場合に生じる長いグランドリターン経路が避けられます。グランドリターン経路が長くなると、寄生インダクタンスが発生し、意図しないフィードバックループが形成される可能性があります。電源デカップリングに関する主な考慮事項は、DC電源接続を電気的にACグランドとして定義する必要があるということです。
デカップリングまたはバイパスコンデンサの選択
実際のコンデンサでは、自己共振周波数(SRF)のために有効周波数範囲が限定されています。SRFの情報はメーカーから提供されていますが、直接測定による特性評価が必要になる場合もあります。SRFを超えると、コンデンサが誘導性を持つため、デカップリングやバイパスの機能を発揮しなくなります。広帯域のデカップリングが必要である場合、標準的な手法は、サイズ(静電容量)を段階的に増やした複数のコンデンサを、すべて並列に接続して使用することです。通常、コンデンサが小容量であればSRFが高くなり(たとえば、0402 SMTパッケージで容量が0.2pFの場合、SRF = 14GHz)、大容量であればSRFが低くなります(たとえば、同じパッケージで容量が2pFの場合、SRF = 4GHz)。標準的な構成を表2に示します。
| Component | Capacitance | Package | SRF | Useful Frequency Range* |
| Ultra-High Range | 20pF | 0402 | 2.5GHz | 800MHz to 2.5GHz |
| Very High Range | 100pF | 0402 | 800MHz | 250MHz to 800MHz |
| High Range | 1000pF | 0402 | 250MHz | 50MHz to 250MHz |
| Midrange | 1µF | 0402 | 60MHz | 100kHz to 60MHz |
| Low Range | 10µF | 0603 | 600kHz | 10kHz to 600kHz |
| *有効周波数範囲の下端は、容量性リアクタンス5Ω未満と定義しています。 | ||||
バイパスコンデンサのレイアウトに関する考慮事項
電源ラインがACグランドでなければならないため、ACグランドのリターン経路に加わる寄生インダクタンスを最小限に抑えることが重要です。これらの寄生インダクタンスは、デカップリングコンデンサのグランドの向きなど、レイアウトや部品の向きの選択によって発生することがあります。図10と図11に示す、2つの基本的な方式があります。
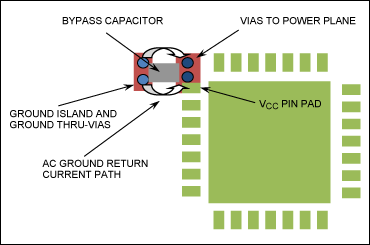
図10. この構成ではバイパスコンデンサとそれに関連したビアの総実装面積が最小
この構成では、最上層のVCCパッドを内部の電源プレーン(層)に接続するビアによって、ACグランドの電流リターンが妨げられ、不可避的にリターン経路が長くなるため、寄生インダクタンスが増大する可能性があります。VCCピンに流れ込むすべてのAC電流は、内部のグランド層に戻る前に、グランド側へ向かってバイパスコンデンサを通過します。この構成では、バイパスコンデンサとそれに関連したビアの総実装面積が最小になります。

図11. この構成ではより大きなPCB面積が必要
このもう1つの構成では、ACグランドのリターン経路が電源プレーンのビアによって妨げられません。一般に、この構成の方がやや大きなPCB面積を必要とします。
シャント接続部品の接地
シャント接続(接地)部品(電源デカップリングコンデンサなど)に対して推奨される手法は、部品ごとに2つ以上のグランドビアを使用することです(図12)。これによって、ビアの寄生インダクタンスの影響が低減されます。シャント接続部品のグループには、ビアグランド「アイランド」を使用することができます。

図12. 部品ごとに2つ以上のグランドビアを使用すると、ビアの寄生インダクタンスの影響が低減
ICのグランドプレーン(「パドル」)
大部分のICは、その直下のコンポーネント層(PCBの最上層または底層)にソリッドグランドプレーンを必要とします。このグランドプレーンによって、DCおよびRFリターン電流がPCB内を割り当てられたグランドプレーンまで流れます。この部品の「グランドパドル」の副次的な機能はヒートシンクの提供であるため、このパドルには、PCBの設計規則が許す最大数のスルービアを設ける必要があります。下の例は、5 × 5配列のビアホールをRF ICの直下にある(コンポーネント層の)中央グランドプレーンに埋め込んだ場合を示しています(図13)。レイアウトに関する他の考慮事項にも適合可能な最大数のビアを使用します。これらのビアはスルービア(PCBを貫通するビア)にするのが理想的であり、めっきを施す必要があります。可能な場合、これらのビアに熱伝導性のペーストを満たしてヒートシンクを強化します(このペーストは、ビアにめっきを施した後、基板の最終めっき処理の前に注入します)。
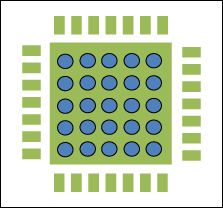
図13. 5 × 5配列のビアホールをRF ICの直下にある中央グランドプレーンに埋め込んだ例
この記事に関して
製品カテゴリ
{{modalTitle}}
{{modalDescription}}
{{dropdownTitle}}
- {{defaultSelectedText}} {{#each projectNames}}
- {{name}} {{/each}} {{#if newProjectText}}
-
{{newProjectText}}
{{/if}}
{{newProjectTitle}}
{{projectNameErrorText}}



















